sputtering공정은 플라즈마를 통해 양이온이 전기장의 힘을 받아 음극으로 가속되는 현상을 이용한 공정이다. 가속된 양이온은 음극과 충돌하게 되며, 충돌에너지가 큰 경우에는 음극을 구성하고 있는 물질의 표면에서 원자를 떼어낼 수 있다.
볼 풀이 있다고 생각해보자.

여기에 농구공을 아주 세게 던진다고 생각하면 볼들이 튕겨져 나와서 주변 벽면에 부딪힐 것이다.
벽면을 기판이라고 생각하면 쉽다. 벽면에 부딪힌 볼들이 증착되는 것이 sputter 공정이다.
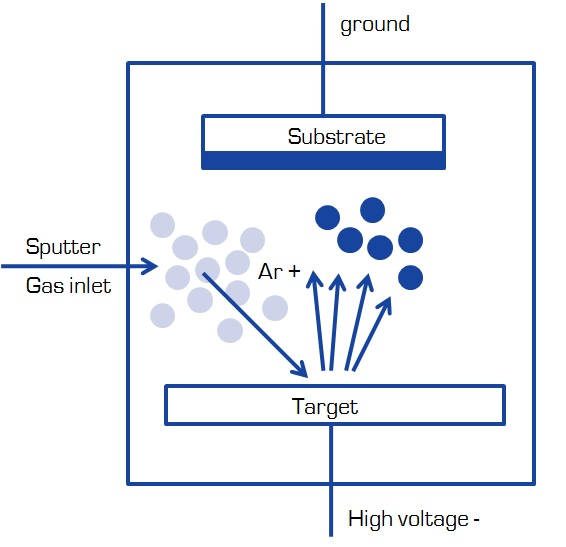
Sputter 장비의 구성

- pumping : 1차, 2차 펌프가 연결되어 있다.
- power supply : 음극에 전원을 공급하며 DC라 써놓긴 했지만 AC를 써도 된다. 대부분의 경우, AC주파수 중 13.56Hz의 주파수를 가진 고주파 (RF) 교류를 사용한다.
- Gun : 타겟을 장착하고 전원과 연결되어 음극으로 작용한다. 내부에는 타겟의 냉각을 위한 냉각수가 흐르고 있고, power supply로부터 전원을 공급받기 위한 전선이 하나 있다.
- Target : 기판에 코팅하고자 하는 물질이다. Gun의 위쪽에 장착되어 실질적으로 음극표면의 역할을 하게 되고, 플라즈마에서 발생된 이온은 이 타겟을 때린다. 그리고 타겟 표면에서 원자 및 분자가 튕겨져 나가 기판에 달라붙는다.
- Substrate : 기판이라고 한다. 필요에 따라 가열을 위한 히터가 달려있을 수 있으며, 냉각을 위한 냉각시스템이 존재한다. 또한 고른 증착을 위해 회전도 가능하다. 타겟인 음극에 대응하여 양극으로 작용한다.
- Shutter : 기판과 타겟 사이를 차단하는 개폐식 문이다. 원하는 곳에, 원하는 시간만큼 증착을 하기 위해 순간적으로 차폐해 주는 장치다.
- Gas system : 챔버 내에 Ar가스를 공급하는 장치이다. 원하는 양의 가스를 정확히 챔버 내에 주입하며, 이때 gas의 양은 sccm이라는 단위로 들어간다. sccm은 standard cubic centimeter per minute를 의미한다. 즉 Ar gas 1sccm이라고 하면, 1분 동안 가로-세로-높이가 각 1cm인 부피에 해당하는 만큼의 Ar gas가 유입된다는 뜻이다.
- Cathode Shield : 쉴드라고 부른다. 장착된 타겟에서 원하는 부분만 스퍼터링 되게 하고, 방전의 안정성 유지를 위해 장착한다. (Gun의 일부로 같이 만들어지며 target과는 전기적으로 독립이 되어야 한다. 전기적 접촉이 있다면 방전이 되질 않아 플라즈마가 발생하지 않는다.)
Spttuer에서 음극의 역할_타겟이 도체일 때
스퍼터링장치에서 음극은 타겟(도체)이 대신하고 있다.
스퍼터링에서는 방전을 시켜주기 위한 방전용 가스로 보통 Ar가스를 사용한다.
- 챔버를 진공으로 충분히 뽑는다.
- 방전가스인 Ar을 주입한다.
- 적당한 챔버 내 압력을 조절한다
- 타겟에 직류 음극의 전기장을 공급하게 되면 방전이 시작되어 플라즈마가 발생한다.
- Ar은 1차 및 2차 전자와의 충돌로 이온화가 되어 양이온인 Ar+와 전자로 분리된다.
- Ar+은 전기장의 힘을 받아 음극인 타겟 쪽으로 가속되어 끌러간다.
- 가속된 Ar양이온과 타겟이 충돌한다.
- 충돌에너지를 통해 타겟물질이 튀어나오게 된다.
타겟은 음극이기 때문에 Ar 양이온이 충돌하면 전자를 얻고 중성아르곤으로 바뀐다. 이렇게 튕겨져 나간 Ar중성입자들은 플라즈마 내에서 또다시 전자와 충돌하여 이온화하여 양이온이 되고, 다시 음극의 전기장에 의해 같은 과정을 반복하게 된다.
Ar 양이온만이 타겟과 충돌하게 되는 것이 아니다. Ar양이온이 타겟쪽으로 이동하는 중에 튕겨져 나온 Ar중성입자와 충돌하여 중성입자로 변할 수 있다. (Ar양이온→Ar중성입자)
이렇게 변한 중성입자는 전기장의 영향을 받지 않는다. 하지만 초기 가속력을 그대로 가지고 있기 때문에 중성화되었어도 타겟과 충돌하게 된다.
타겟이 부도체일 때
타겟이 부도체인 경우 직류를 인가하여 음극으로 사용할 수 없다.
부도체에 음극(직류)를 인가했을 때를 생각해 보면, 방전 초기에는 도체의 DC방전과 똑같은 현상이 일어난다.
부도체에 자유전자가 없지만 한쪽에 전압이 가해지면 내부에서 유전분극에 의해 극성을 나타낼 수 있다. 따라서 Ar 양이온이 음극 쪽으로 가속되어 끌려갈 수 있다.
하지만 자유전자가 존재하지 않기 때문에 타겟과 충돌한 아르곤 양이온들은 중성화되지 않고 타겟 표면에 쌓이게 된다. 이는 양이온의 가속을 멈추게 하며, 전극에 충돌하기 위한 충분한 에너지를 얻지 못하게 한다.
self bias (자기 바이어스)
- RF시, 타겟이 (-)일때 양이온이 들어오고 타겟이 (+)일때 전자가 들어온다.
- 전자의 속도가 양이온보다 빠르므로 전자가 더 많아져 타겟은 음으로 대전되어 본래 전위보다 더 낮아진다.
- RF는 +,- 전류를 균일하게 교차해 출력하므로 순전류는 0이어야 하지만 전자가 더 많다.
- 지속적으로 들어오는 전자에 의해 전극은 더 (-)로 전위가 낮아지고, 그로 인해 더 많은 양이온이 유입된다.
- 앞의 과정이 반복되며 들어오는 전자수=양이온수 (순전류=0)이 될 때까지 전위가 낮아진다.
- 타겟은 음극인 상태를 오래 유지할 수 있고 양이온은 타겟으로 가속되어 스퍼터링 일으킨다.
요약
처음엔 타겟에 양이온이 모인다. 그다음에 (+)에서 전자들이 오는데, 전자의 속도가 더 빠르기 때문에 양이온보다 더 많은 수가 들어온다.
따라서 타겟은 중성이 아닌 음의 값을 갖는다.
이 과정이 반복되면 더더욱 타겟이 음의 값은 갖게 된다. 따라서 더 많은 양이온이 들어올 수 있고 전자의 유입은 반대로 줄어들게 된다.
그래서 어느 순간 타겟에 들어오는 전자수와 양이온수가 평형을 이루어 순전류=0인 조건을 만족시키는 음전위가 형성되게 된다.
그렇게 되면 타겟은 이제 고정적인 음극 역할을 할 수 있게 된다.
자기 바이어스에 의해 타겟이 음극으로 고정되어 버리면 양이온은 타겟만 때리게 된다. 따라서 기판에서 스퍼터링이 일어나지 않는다.
부도체 타겟을 사용하는 것과 부도체 박막을 형성하는 것은 독립적이다.
DC파워로 부도체 타겟을 사용할 순 없지만, 부도체 박막을 형성할 순 있다.
TiO2라는 물질을 기판에 증착하고자 할 때, 타겟에 부도체를 사용하게 되면 DC파워로 증착이 불가능하다.
따라서 Ti를 타겟물질로 사용하고 O2(반응성가스)를 주입해서 Ti와 만나게 해주면 된다.
이런 방식을 통해 TiO2가 기판에 증착되어 박막을 형성할 수 있고, DC파워를 사용하여 원하는 거의 모든 산화물 박막을 만들 수 있다. (AlO3, TiN 등)
하지만 탄소는 가스가 아니므로 탄소가 포함되어 있는 메탄가스(CH4)나 아세틸렌(C2H2)를 넣어준다. 이때 H2는 가스로 배출된다.
이러한 방식을 반응성 스퍼터링(reactive sputtering) 법이라고 한다.
반응성 스퍼터링은 DC파워뿐만 아니라 RF파워일 때도 사용한다. (화학양론비를 정확히 맞춰주기 위해 손실된 gas를 추가로 넣어서 약간의 반응성 스퍼터링을 일으킨다. 그리고 일부로 비화학양론적 물질 등의 비평형상, 고용체를 만드는 경우에도 흔히 사용된다.)
'공정법' 카테고리의 다른 글
| Etching (0) | 2023.10.23 |
|---|---|
| Photolithography (1) | 2023.10.23 |
| Metallization _ Damascene Process (1) | 2023.10.23 |
| Oxidation 공정 (1) | 2023.10.21 |



