728x90
BEOL(Back End Of Line, 후공정)에서는 수평면으로 금속선 회로를 깔고, 수직 방향으로는 소자가 외부와 소통할 수 있도록 소자의 4개 단자와 연결하는 콘택트(Contact)와 비아홀(Via Hole)을 형성한다. 소자와 소자, 소자와 외부를 잇는 이 같은 과정을 ‘Metallization 공정’이라고 한다.
용어
contact : 다른 물질 간의 접합부위
interconnection : contact들을 서로 연결한 metal line
metallization : interconnection을 만드는 공정 (→ 원하는 형태의 회로를 구성한다. → 층이 여러 개가 형성된다.)
IMD(inter metal dielectric) : metal 사이의 절연물질
via : metal 사이의 연결을 하는 층 (연결부위)
공정의 핵심
- resistivity가 낮춰서 RC delay와 voltage drop을 개선해야 한다.
- 장시간의 reliability와 물리적, 화학적으로 안정한 물질인지 확인해야 한다.
- patterning이 쉬워야 한다.
- 가격이 싸야한다. 예전에는 Al을 써서 interconnection을 만들었지만 요즘은 Cu를 사용하여 만든다.
Metallization 물질
- Au (gold) : silver와 같은 단점이 존재한다.
- Si에 매우 빠르게 diffusion한다.
- gold 이온들이 diffusion하여 trap을 생성하며 Si와의 adhesion이 좋지 못하다.
- 뜯겨 나간다. 따라서 adhesion layer (Ti, Ta, W, Cr)을 증착한 뒤 증착해야 한다.
- Au가 비싸다.
- Al
- 싸다
- Si, SiO2와 adhesion이 좋다. (adhesion layer 필요 없다.)
- patterning이 쉽다. (wet etching, dry etching 쉽다.)
- eutectic 발생 : 녹는점이 낮아진다.
- 부식, electonmigration, junction spiking과 같은 문제점이 발생한다.
- 순수한 Al이 녹는점은 660도이며 Si이 녹는점은 1414도이다.
- 450~500도에서 annealing을 진행하여 증착한다. 이때 contact resistivity가 줄어들다가 450도 정도일 때 저항이 급격히 낮아지는 현상이 발생한다.
junction spike
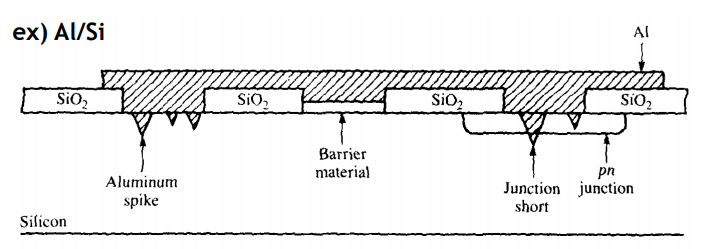
- Al과 Si 경계면에서 합금이 형성되고 합금의 녹는점이 낮아진다.
- Si이 Al 쪽으로 흡수되어 버린다. Al이 Si 쪽으로 파고드는 부분 형성 (junction spike) → n+를 넘어서 형성될 수도 있음
- 전기적으로 short 시키거나 추가적인 leakage current를 발생시킨다. 이는 회로의 성능을 저하시킨다.
solution
- barrier layer (poly -Si or metal)을 삽입한다. 하지만 비저항 측면에서 손해이다 (낮은 비저항 물질 : Al)
- Al 증착 시 1%의 Si이 포함된 Al을 증착한다. 이를 통해 Al-Si의 녹는점을 600도까지 올릴 수 있다.

electromigration
- Al interconnection에 전압을 인가하여 전류를 흘려준다.
- 높은 전류가 흐른다면 전자가 가진 momentum이 크다.
- Al 원자를 이동시켜 버린다. (void→ 날아간 부분이 hillock, bridge을 발생시킨다.)
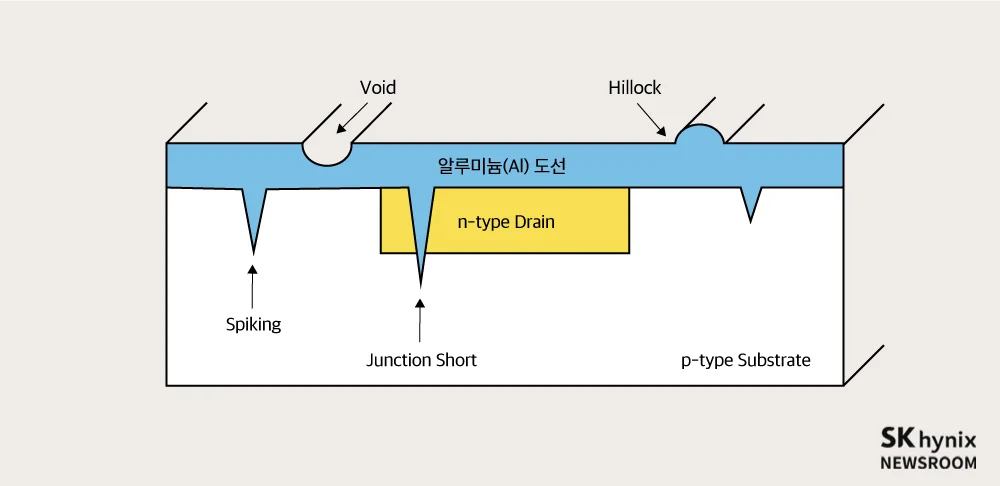
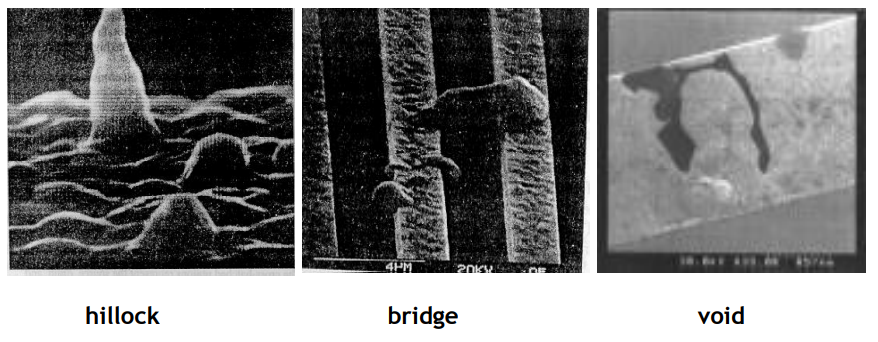
solution
- Cu와 같은 heavy metal의 비율을 약간 늘린다.
- magic number : 95% Al + 4% Cu, 1% Si을 이용한다. 하지만 electromigration과 spike 문제를 해결하기 어렵다.
- 이러한 문제는 Damascene Process로 해결되었다.
- Cu
- 비저항이 Al보다 좋다.
- Si와 접합 시 매우 빠르게 확산한다.
- etching이 어렵다.
- 현재는 Damascene Process를 적용하여 해결했다.
- 이 같은 구리의 문제점을 해결하기 위해서는, 먼저 구리의 확산을 막기 위한 베리어를 설치한다. 이는 알루미늄인 경우와 유사하게 실리콘/SiO2와 구리 사이에 추가적인 베리어를 형성하는 방법이다. 또한, 구리막이 식각되지 않는 문제는 다마신이라는 상감기법을 적용해 해결한다. 다마신이란 미리 만들어 놓은 틀 속에 용융된 금속 액체를 주입해 넣듯, 전해도금(Electroplating)으로 구리를 채워 넣는 방식을 말한다.
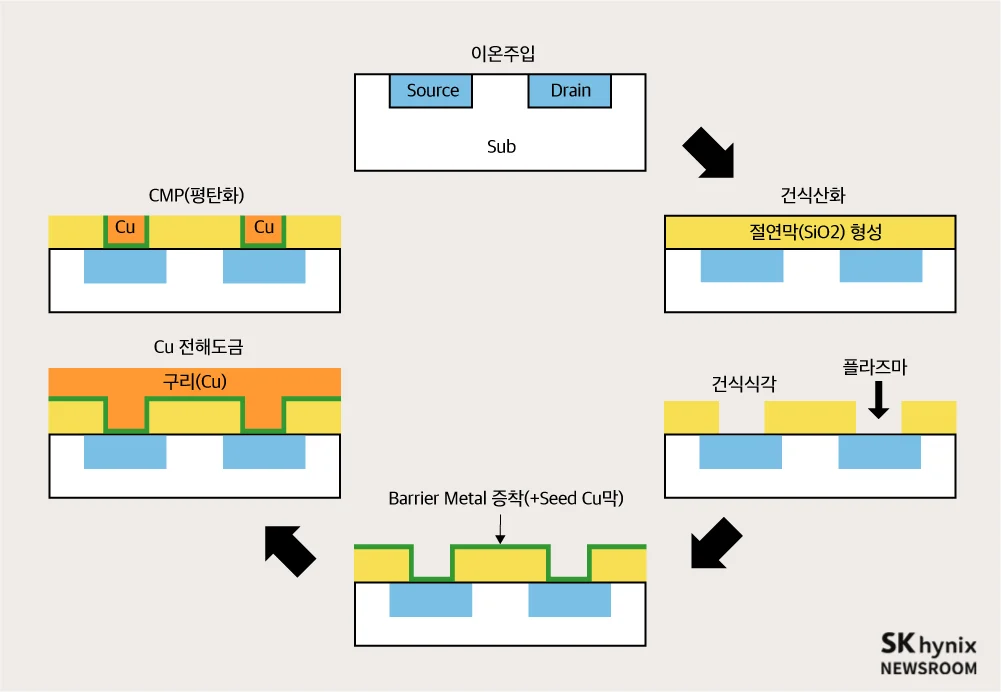
- IMD (절연체 층 = ILD)을 깎아준다.
- barrier layer 증착 : 주로 metal : Cu가 diff 하는 걸 막음
- Cu Seed 측을 증착한다. : 전기가 흐를 수 있는 층
- 전류를 흘려주면서 Cu층을 형성시킨다. (전기도금 )
- CMP 공정을 통해 매끄럽게 갈아준다. (Cu를 에칭 할 공정이 없다)
single Damascene : Cu metallization + W via
dual Damascene : Cu metallization + Cu via
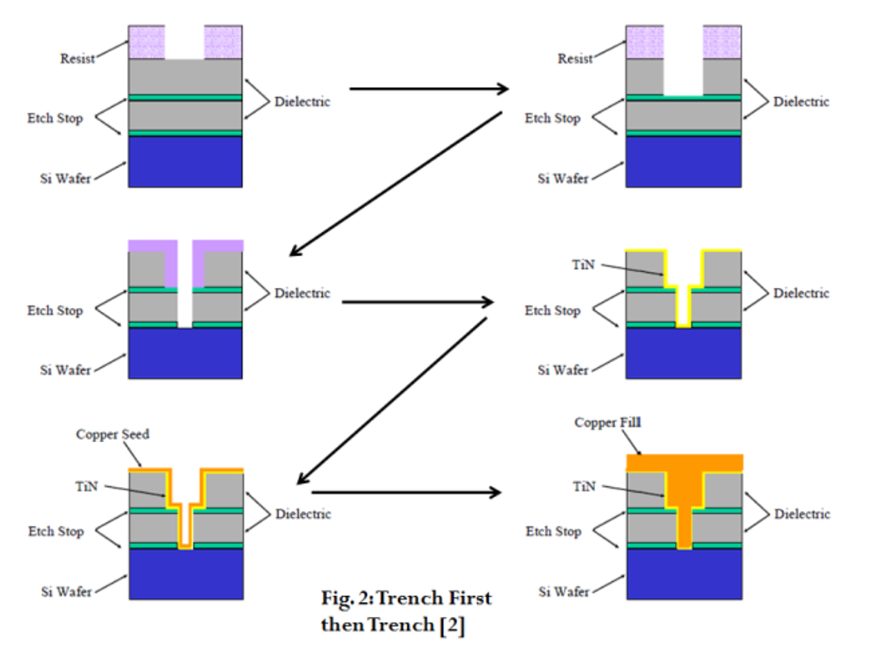
728x90
'공정법' 카테고리의 다른 글
| Etching (0) | 2023.10.23 |
|---|---|
| Photolithography (1) | 2023.10.23 |
| Oxidation 공정 (1) | 2023.10.21 |
| Sputter (1) | 2023.10.20 |



