728x90
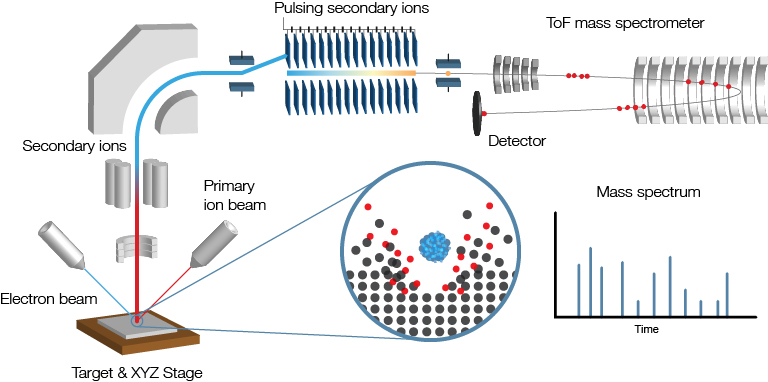
TOF-SIMS (Time of Flight Secondary Ion Mass Spectroscopy)는 표면 분석 기법 중 하나로, 샘플 표면에 고속 이온 빔을 조사하여 생성된 이차 이온들의 질량을 시간 비행 방식으로 측정하는 방법이다.
- 원리
- 샘플 표면에 고에너지 이온 빔 (예: Ga+, Bi+)을 조사하면, 샘플로부터 이차 이온들이 방출된다.
- 이 방출된 이차 이온들은 전기장 내에서 가속되어 비행 튜브를 통과하게 된다.
- 이온들의 비행시간은 그들의 질량과 에너지에 따라 달라진다. 따라서, 이온들의 비행시간을 측정함으로써 질량을 결정할 수 있다.
- 응용
- TOF-SIMS는 샘플 표면의 화학적 구성, 원소 분포, 분자 구조 등의 정보를 제공한다.
- 극미량의 물질도 검출할 수 있으며, 고해상도의 이미징도 가능하다.
- 장점
- 극미량의 물질도 높은 감도로 검출 가능하다.
- 다양한 원소와 분자에 대한 정보를 동시에 얻을 수 있다.
- 표면의 극소 영역에서도 분석이 가능하여, 고해상도의 이미징 분석이 가능하다.
- 제한점
- 깊은 층의 정보를 얻기 어렵다. 주로 표면 및 표면 근처의 정보에 초점을 맞춘다.
- 샘플의 전처리나 특정 조건 하에서의 분석이 필요할 수 있다.
Time of flight mass analyzer
모든 이온들이 가속장에서 같은 에너지를 받고 검출기까지 가속화되면서 가벼운 이온은 먼저, 무거운 이온은 나중에 검출되는 원리에 의해 분석 물질을 분리하는 방법이다.

TOF-SIMS로 분석한 표면 분석이다.
IGZO란 InO, GaO, ZnO의 화합물이다. 이 논문에서 사용된 IGZO의 비율은 1:1:1로 첨가되어서 TOF-SIMS 분석 시 Zn과 Ga, In가 어느 정도 비슷하게 나와야 한다.
하지만 분석 결과 Zn가 약 100배정도 낮게 측정된다.
TOF-SIMS 장비업체에 문의해본 결과 TOF-SIMS에서 잘 검출하는 원소가 있고 잘 검출하지 못하는 원소가 있다고 전해 들었다. 이러한 차이로 인해 분석결과가 이상하게 나온 것이지, In, Ga, Zn의 질량차이에 따라 intensity가 낮게 나오거나 뭐 그런 건 아니다.
728x90
'분석법' 카테고리의 다른 글
| 4-point probe (Kelvin probe) (1) | 2023.10.31 |
|---|---|
| UV-vis spectroscopy (UV-visible spectroscopy) (0) | 2023.10.25 |
| UPS (UV photoelectron spectroscopy) (0) | 2023.10.25 |
| Tauc Plot (0) | 2023.10.25 |



